이규제 SK하이닉스 부사장 "차세대 패키징 기술로 HBM 1등 이어갈 것"
[서울=뉴스핌] 김정인 기자 = 이규제 SK하이닉스 PKG제품개발 담당 부사장이 차세대 패키징 기술로
고대역폭메모리(HBM) 1등 리더십을 이어갈 것이라는 자신감을 드러냈다.
이 부사장은 5일 SK하이닉스 뉴스룸에 공개된 인터뷰에서 "표준 규격에 따라 제품 두께는 유지하면서도 성능과 용량을
높이기 위한 칩 고단 적층의 방편으로 최근 하이브리드 본딩 등 차세대 패키징 기술이 주목받는다"며 "위아래 칩간 간격이
좁아져 생기는 발열 문제는 여전히 해결해야 할 과제이지만, 점점 더 다양해지는 고객의 성능 요구를 충족시킬 솔루션으로
기대를 모으고 있다"고 말했다.
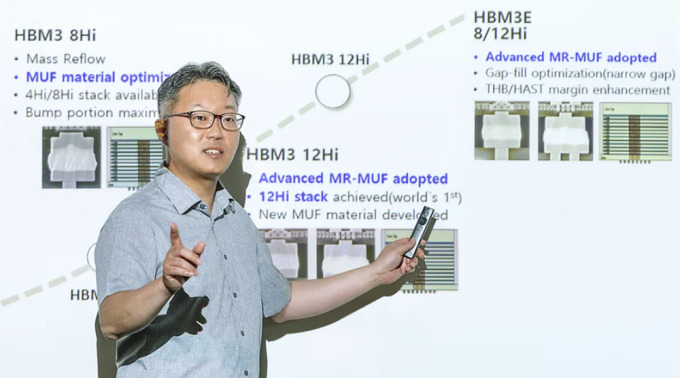 |
| MR-MUF 기술 로드맵을 설명하는 이규제 SK하이닉스 PKG제품개발
담당 부사장. [사진=SK하이닉스] |
이어 "SK하이닉스도 방열 성능이 우수한 기존 어드밴스드 MR-MUF를 지속 고도화하면서 새로운 기술들을 확보해
나갈 계획"이라고 강조했다.
SK하이닉스는 2023년에 4세대 12단 HBM3와 5세대 HBM3E 개발에 연이어 성공하며 HBM 시장을 주도하고
있다. 이 부사장은 HBM 성공의 1등 공신으로 MR-MUF 기술을 한 번 더 고도화한 '어드밴스드(Advanced)
MR-MUF'를 꼽았다.
이 부사장은 "12단 HBM3부터는 기존보다 칩의 적층을 늘렸기 때문에, 방열 성능을 더욱 강화해야 했다. 특히
기존 MR-MUF 방식으로는 12단 HBM3의 더 얇아진 칩들이 휘어지는 현상 등을 다루기 쉽지 않았다"고 전했다. 이어
"이러한 한계를 극복하기 위해 회사는 기존의 MR-MUF 기술을 개선한 어드밴스드 MR-MUF 기술을 개발했다"며 "이를
통해 지난해 세계 최초로 12단 HBM3 개발 및 양산에 성공했으며, 이어 올해 3월 세계 최고 성능의 HBM3E를
양산하게 됐다"고 했다.
해당 기술은 하반기부터 인공지능(AI) 빅테크 기업들에 공급될 12단 HBM3E에도 적용되고 있으며, 이후 활용
범위가 더 넓어질 것이라는게 회사 측 설명이다.
kji01@newspim.com
SK하이닉스 (KOSPI:000660)
과거 데이터 주식 차트
부터 8월(8) 2024 으로 9월(9) 2024

SK하이닉스 (KOSPI:000660)
과거 데이터 주식 차트
부터 9월(9) 2023 으로 9월(9) 2024

에스케이하이닉스보통주 ()의 실시간 뉴스: 최근 기사 0
More SK Hynix Inc News Articles